应用材料公司解决2D尺寸继续微缩的重大技术瓶颈
2020年7月20日, 应用材料公司宣布推出一项新技术,突破了晶圆代工-随逻辑节点2D尺寸继续微缩的关键瓶颈。
应用材料公司最新的选择性钨工艺技术为芯片制造商提供了一种构建晶体管和其它金属导线连接的新方法,这种连接作为芯片的第一级布线,起着至关重要的作用。创新型选择性沉积降低了导线电阻,从而提升晶体管性能并降低功耗。有了这项技术,晶体管及其导线的节点可以继续微缩到5纳米、3纳米及以下,从而实现芯片功率、性能和面积/成本(PPAC)的同步优化。
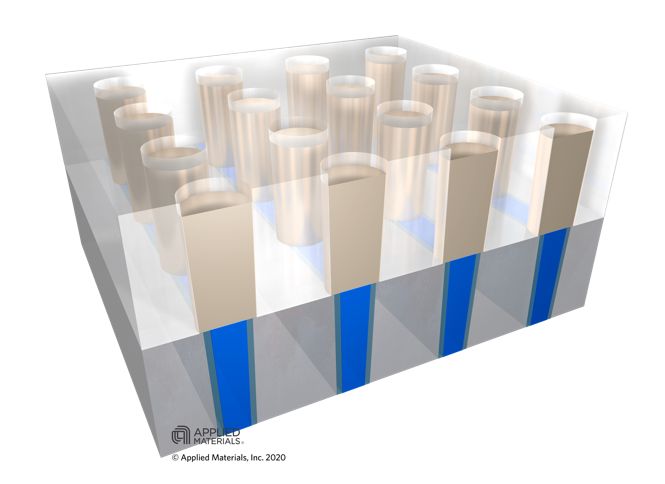
应用材料公司创新的选择性钨工艺技术消除了在先进晶圆代工-随逻辑节点微缩而阻碍晶体管功率和性能的导线电阻瓶颈
虽然光刻技术的进步使得晶体管导线通孔可以进一步缩小,但是,传统的金属填充导线通孔的方法已成为PPAC优化的一个关键瓶颈。
长久以来,导线一直通过多层工艺完成。首先在通孔内壁涂覆一层由氮化钛制成的粘附阻挡层,然后成核层,最后用钨填充剩余空间,首选钨作为填孔金属是因为它的电阻率很低。
在7纳米晶圆代工节点,导线通孔直径只有20纳米左右。粘附阻挡层和成核层约占通孔容积的75%,只剩25%左右的容积用于填钨。细钨丝电阻很高,使PPAC优化和进一步的2D尺寸微缩遭遇重大瓶颈。
VLSIresearch董事长兼首席执行官Dan Hutcheson表示:“随着EUV的出现,我们需要解决一些关键性的材料工程挑战才能让2D尺寸微缩继续发展。在我们这个行业,粘附阻挡层就像医学里的‘动脉斑块’,它剥夺了芯片达到最佳性能所需的电子流。应用材料公司的选择性钨沉积是我们期待已久的突破。”
选择性钨沉积
应用材料公司最新的Endura® Volta™ selective Tungsten CVD系统使得芯片制造商可以选择性地在晶体管导线通孔进行钨沉积,完全不需要粘附阻挡层和成核层。整个通孔用低电阻钨填充,解决了PPAC持续微缩所面临的瓶颈。

应用材料公司最新的Endura® Volta™ selective Tungsten CVD系统
应用材料公司的选择性钨工艺技术是一种集成材料解决方案,结合了洁净度比洁净室高许多倍的超洁净、高真空环境下的多项工艺技术。对晶圆进行原子级的表面处理并采取独特的沉积工艺,使得钨原子在通孔选择性沉积,实现无脱层、无缝隙、无空洞完美地自下而上填充。
应用材料公司半导体产品事业部副总裁Kevin Moraes表示:“数十年来,行业依赖于2D尺寸微缩来驱动功率、性能和面积/成本(PPAC)的同步优化,但是如今,由于所要求的微缩几何形状太小,我们越来越接近传统材料和材料工程工艺的物理极限。我们的选择性钨工艺技术集成材料解决方案,是应用材料公司通过创造新的工艺来满足微缩需求而无需在功率和性能上妥协的完美例证。”
全新的Endura系统已经成为全球多个领先客户的选择。应用材料公司创新的选择性加工工艺已经成熟地运用于选择性外延、选择性沉积与选择性移除上,而应用在Endura平台上还是首次。这些选择性加工技术使得芯片制造商能以全新的方式创制、塑造、调整材料,持续推动PPAC的进步。
| 上一篇:华虹半导体持续打造卓越... | 下一篇:雷曼光电推出并量产新型... |
声明:本网站部分文章转载自网络,转发仅为更大范围传播。 转载文章版权归原作者所有,如有异议,请联系我们修改或删除。联系邮箱:lynnw@actintl.com.hk













